化镍软金工艺
- FPCB专用镀金工序
- 可形成超微电路
- 优秀的内部曲折性
- 解决镍裂纹问题
 HOME
HOME最终表面处理 用于PCB和半导体等电子材料的最终工序的 Process,主要利用金、银、钯等贵金属镀金化学材料
化镍软金工艺

镍钯金工艺

Soft ENIG Process : CF300-10 series / MIKO series 化镍软金工艺:CF300-10系列 / Miko系列
特性
预处理
软镍EN : CF300-10系列
化学镍金 : Miko系列
循环弯曲50次之后
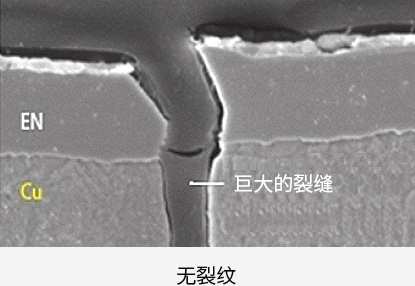
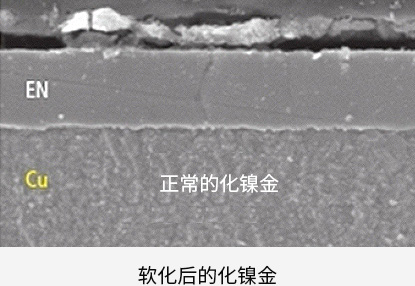
Pd-P(ELP series) or Pure Pd(ZEP series) ENEPIG Process Pd-p(ELP 系列)or Pure Pd(ZEP 系列)沉金工艺
特性
电镀工艺

Electrolytic Gold Process : HG300 & SAU10 series 电解镀金 | 硬金&软金:HG300&SAU10系列
硬金工艺特点
电镀工艺
清洁剂
蚀刻
酸浸
光亮镍
酸浸
金属强度
金属


软金工艺特点
